一、 使用UTA无掩模DLP系统LED光刻二维纳米片器件的金属触点
LED 光刻工艺包括六个步骤:(1) 纳米片沉积,(2) 光刻胶涂层,(3) 图案设计,(4) 使用红光进行对准,(5) 蓝光曝光和 (6) 显影
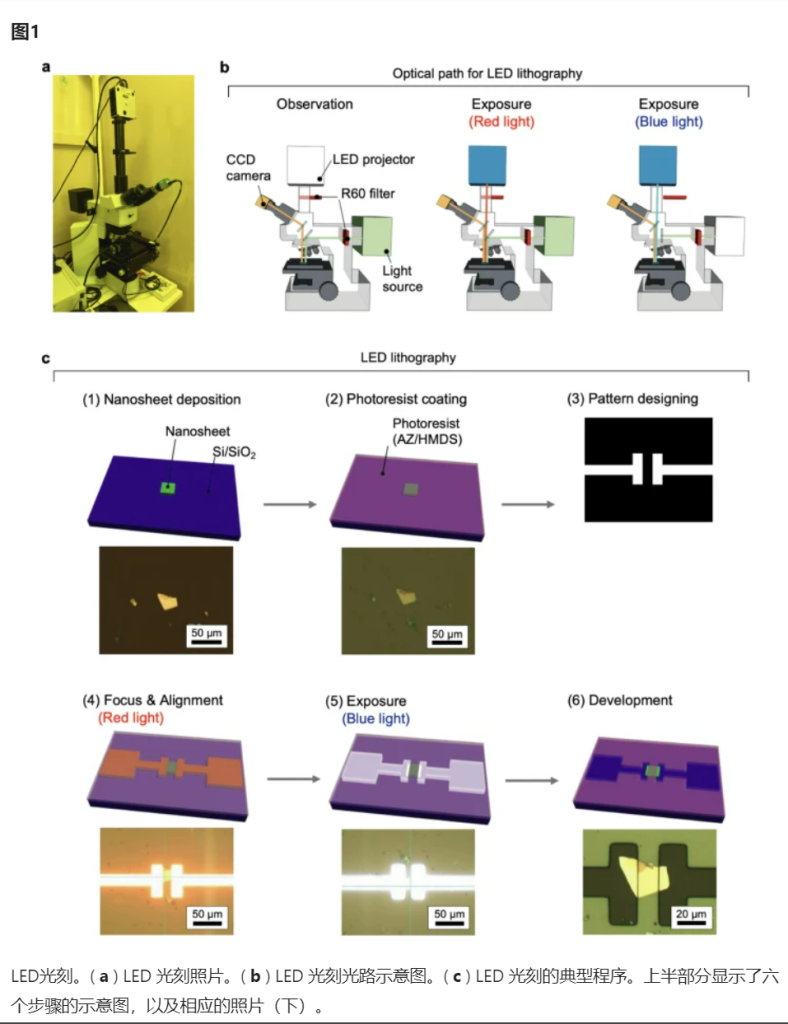
通过 LED 光刻技术制造的 2D 器件的几个示例如下图;

二、通过Optelics Hybrid 混合共焦显微镜表征图案化能力和器件结构;
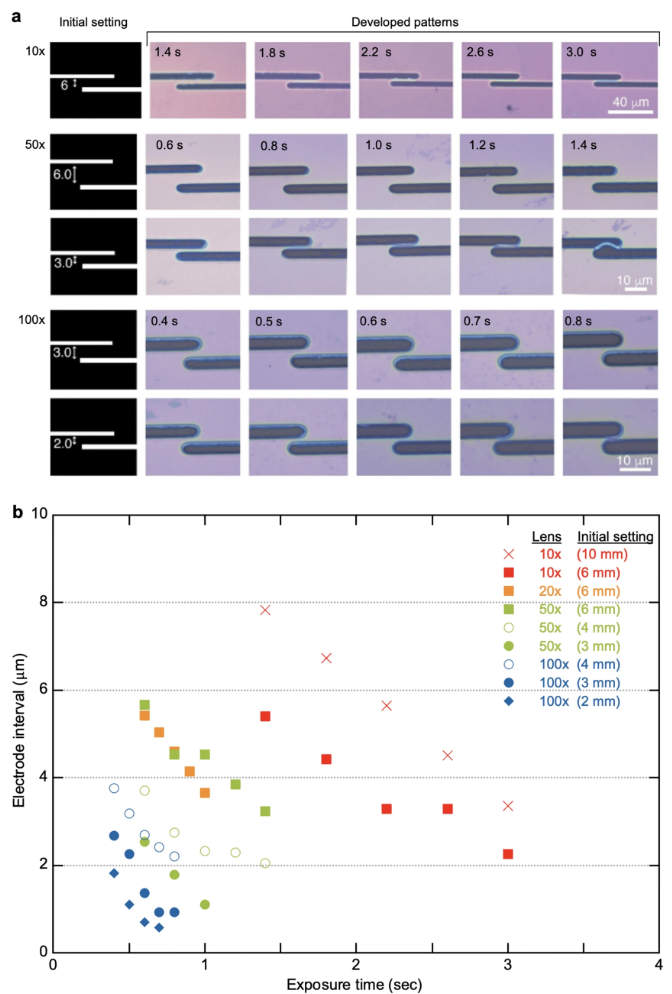
图案化能力。( a ) 与最初设计的图案(左)相比,开发的图案对曝光条件的依赖性。采用不同物镜(×10、×50 和×100)和不同曝光时间的 LED 光刻法制作的两个电极。( b ) 电极间隔与曝光时间的关系。我们评估了由具有不同初始设置的不同物镜制造的电极间隔。
不同放大倍数的曝光会产生具有不同特征尺寸和间隙的电极。图 3b说明了曝光时间对电极间隔的影响。对于具有设定距离的一对电极图案,延长曝光时间会导致电极间距缩小。对于较低的放大倍数(10 倍和 20 倍),最小间隙尺寸达到 3 μm。
三、为了研究 LED 光刻的效用,我们对纳米片器件进行了拉曼表征。
作为第一个测试,我们制造了单层 (1L) MoS 2纳米片的场效应晶体管 (FET) 器件(图 5a)。为了检查层数和可能的损坏,我们表征了拉曼光谱(图 5b),为了检查层数和可能的损坏,我们进行了拉曼光谱(图 5b),图 5c显示了 1L 器件的 FET 特性。
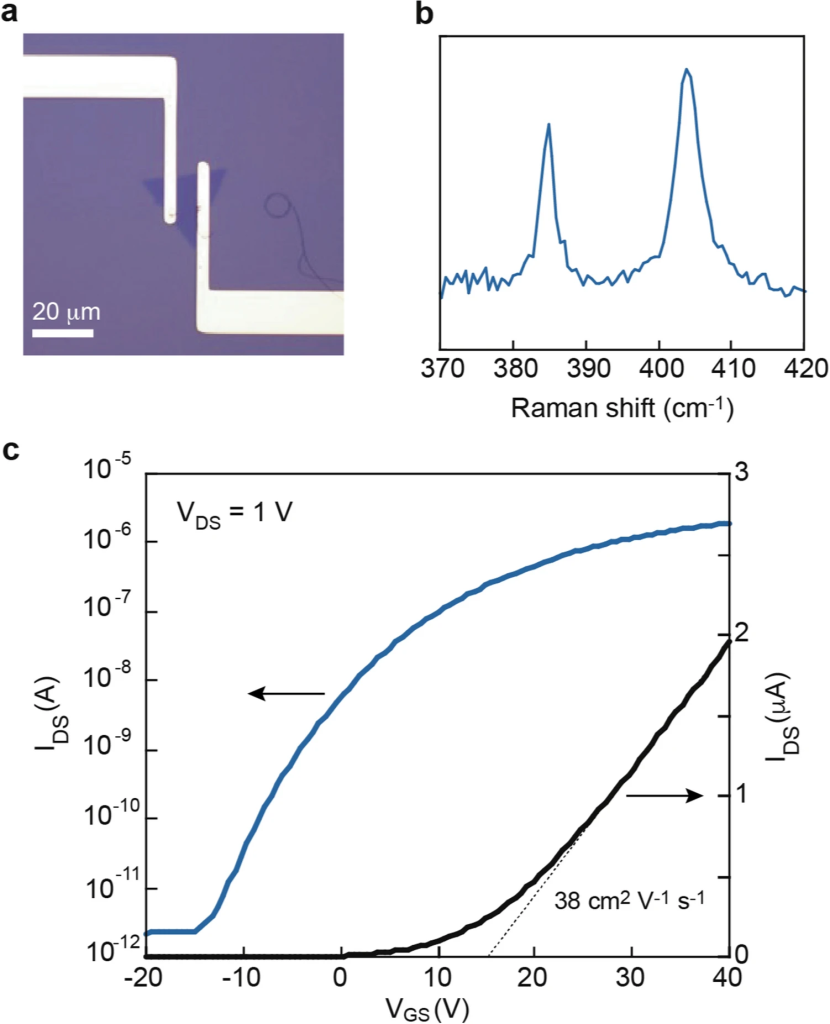
图5,通过 LED 光刻技术制造的 FET 器件。( a ) 290 nm-SiO 2 /Si 上的 1 L MoS 2 FET 。( b ) 取自单层 MoS 2器件的拉曼光谱。( c )在室温下从单层 MoS 2器件测量的转移曲线。
总结:
我们已经展示了使用 LED 光刻技术简单快速地制造 2D 材料设备。在LED光刻中,PC设计的图案可以通过LED投影仪在光刻胶层上精确定位并快速显影,从而实现无掩模光刻,避免了传统光刻中经常遇到的工艺损伤。这种方法特别适用于对传统电子束光刻敏感的二维材料。我们将这种 LED 光刻应用于所选纳米片(MoS 2、GO、r-GO 和 RuO 2), 并实现了特征尺寸小至 1 μm 的各种图案化电极的无损伤光刻。我们的方法使按需设备制造 2D 纳米片免受加工损伤,提供了对 2D 纳米片真实特性的详细了解。
传统的 EB 光刻通常会导致无意的杂质掺杂和晶体损坏,从而降低电子特性。在此背景下,LED光刻技术颇具特色。由于此方法使用蓝色 LED 组件,因此可以实现温和的光刻,避免 EB 光刻中经常遇到的可能的光束损坏。我们的 LED 光刻系统简单且价格低廉,只需将普通光学显微镜与市售 LED 投影仪相结合即可。这是与传统电子束光刻相比的一大优势;商业应用中使用的典型 EB 光刻系统非常昂贵(> 100 万美元)。LED 光刻技术为器件制造提供了一种经济高效的光刻技术,无需任何昂贵的仪器、高真空或复杂的操作。