对于基板反射率明显高于薄膜反射率,激光显微镜通常难以测定的薄膜表面凹凸形貌,我们提供基于反射分光膜厚分布测试解决方案。——当基板是Si晶圆或玻璃等,以此方法,即可快速测出几十nm的膜厚的分布差异。
Si基板上透明薄膜的表面凹凸形貌测定:
概述:对于树脂类、金属类制品等,其表面的几十纳米的凹凸形状,通常可以用共聚焦显微镜测试。但是对于金属等高反射率基板上的薄膜表面的形状测试,在基板反射率明显高于薄膜反射率时,经常无法正确测定。
例如,考虑如图1的Si基板上的单层膜结构。其表面凹凸能否测出,取决于膜厚以及镜头的NA值。使用高NA镜头时,膜厚在几十微米以上时可准确测定,几微米以下薄膜的情况,Si基板的反射光与薄膜表面的反射光难以分离,无法有效测定。
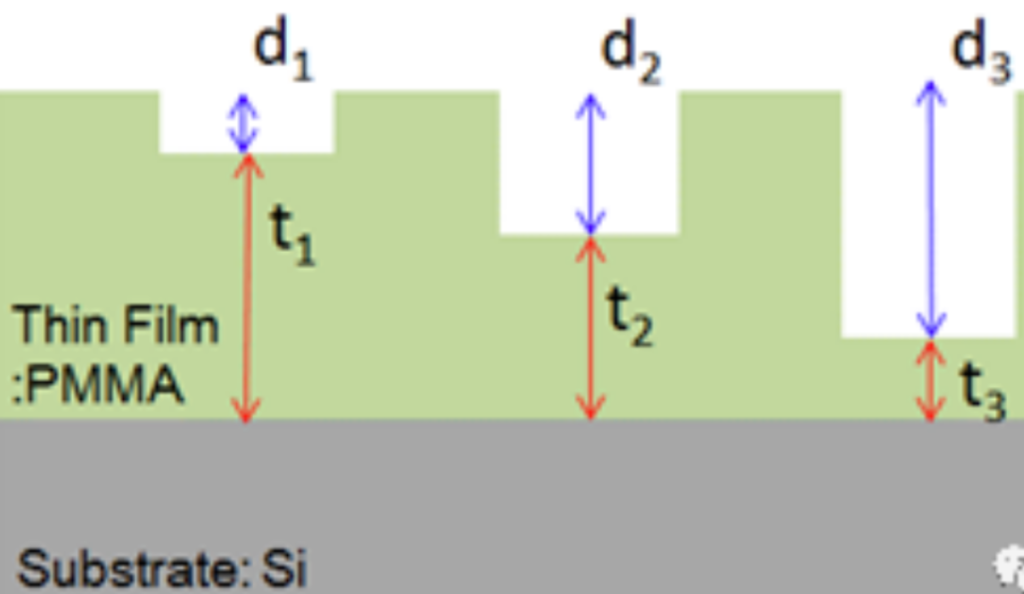
一、测试方法:反射分光法测定膜厚
对于此类测试需求;当基板是Si晶圆或玻璃等平面的场合,可认为由膜厚能够推导出表面形状。以此方法,即可用低倍宽视野镜头快速测出几十nm的膜厚差异。
这里,上图样品由彩色共聚焦模式得到的图像如下图,由于加工的深度不同,8个由透明膜涂覆的凹槽,在图像上看颜色各异。这里,利用薄膜干涉原理,可对薄膜的厚度进行定量测量。

- 彩色共聚焦图像(PMMA膜,Si基板)
- 测定条件:TU10x镜头(NA=0.3)
- 照明波长:白光(氙灯)
二、基于反射分光法的光刻胶膜厚分布测定:
利用6种波长的可见光分别分别获取共聚焦图像,与另外测试得到的标准样品数据对比分析,可得到每一像素点的、各波长的反射率。
无色透明薄膜上之所以出现彩色的干涉光,是由于多重反射受干涉影响或增强或减弱,导致特定波长的反射率变小。
对于特定波长(λ),其反射率强弱由膜厚(t)导致的相位差(θ)决定。

通过自带软件进行曲线拟合,基于最小二乘法得到膜厚结果。

- 图中 分光膜厚分析(4号凹槽:214nm)
- 测定条件:TU10x镜头(NA=0.3)
- 选用波长:436nm,486nm,514nm,546nm,578nm,633nm
三、解析膜厚分布:
视野全体的表面凹凸情况,仅由区域内平均膜厚并不能判断,需要对各像素点分别进行膜厚解析。与上述同样分析条件对全像素点进行解析,得到膜厚分布图像。

图7 膜厚分布图像断面图
测定模式:反射分光
测定条件:TU10x镜头(NA=0.3)

图8 膜厚分布图像断面图 噪声处理后
测定模式:反射分光
测定条件:TU10x镜头(NA=0.3)
分析得到的膜厚分布图像断面图如图7。各凹槽测量位置的深度,与指定区域的平均值基本一致。斜面处反射光无法正常检测的部分,出现噪声干扰,设定亮度阈值可对噪声判定为异常值后进行处理。处理后得到的断面图如图8。可进一步得到3D图像进行直观观察(如图9)。
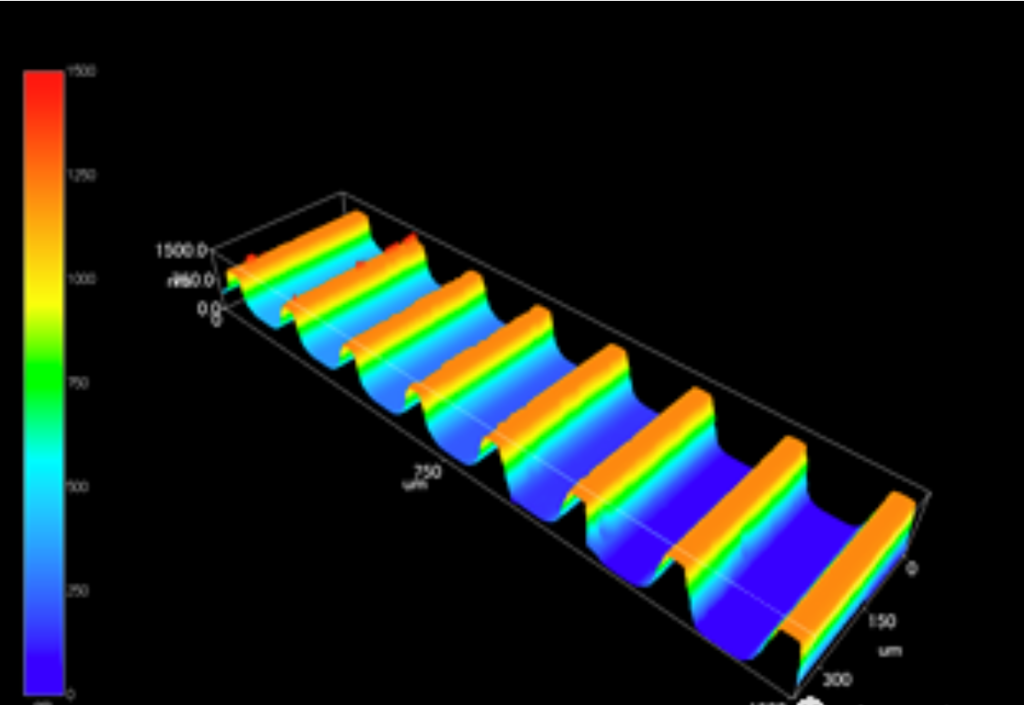
图9 3D图